IMEC:晶圆级光互连系统中硅光谐振型微盘调制器的热挑战与优化策略
在互联网数据流量激增与大模型快速发展的驱动下,数据中心基础设施面临着严峻的成本与能耗压力。为解决数据传输的能效瓶颈,光互连技术已在数据中心广泛应用,而硅光子光收发器的演进正推动着可插拔光模块向共封装光学(CPO)技术过渡,旨在最大限度缩短器件间距、降低寄生损耗。
近年来,系统级晶圆(System-on-Wafer)产品凭借紧密的2D/3D集成优势,在高性能计算(HPC)领域展现出卓越潜力,将光互连技术与系统级晶圆结合,构建晶圆级光互连系统,成为突破数据传输瓶颈的重要方向。然而,这一集成方案给硅光子核心器件——谐振式微盘调制器(Disk Modulator, DM)带来了严峻的热挑战,包括加热器效率损耗与热串扰问题,直接影响器件的稳定运行。针对这个问题,来自imec的研究团队基于实验校准的仿真模型,深入剖析这些热挑战,并提出针对性优化策略。
文章来源:
https://ieeexplore.ieee.org/abstract/document/11283006
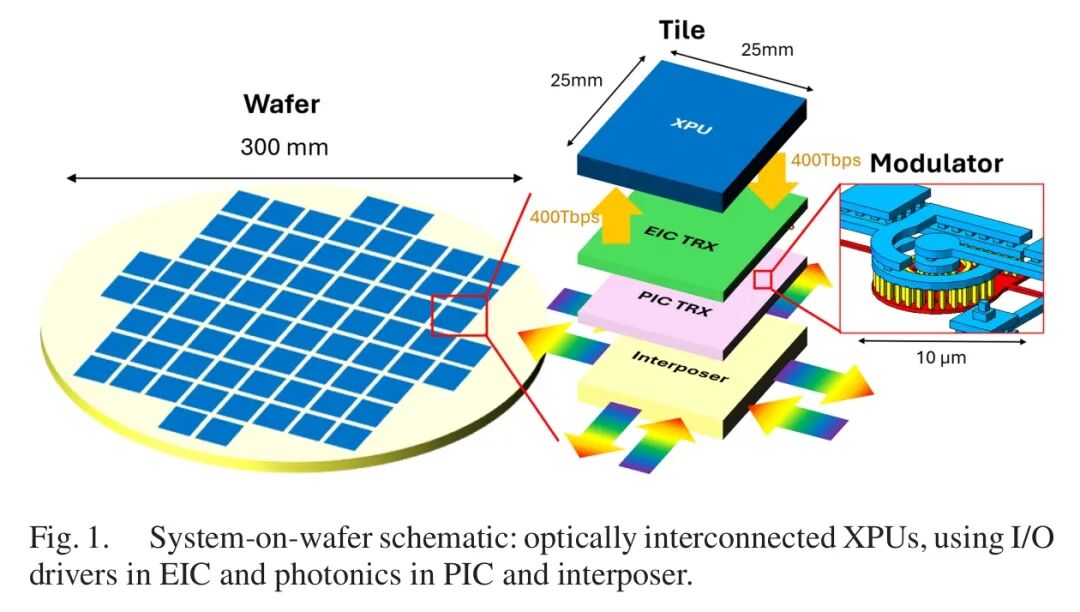
一、建模方法论:多尺度热仿真体系构建
晶圆级光互连系统(OIO3D)的热仿真需覆盖从微米级器件到300mm晶圆的多尺度范围,需兼顾器件精度与计算效率,构建了包含器件级、EIC级、晶圆级的完整建模体系,并明确了功率分布规则。
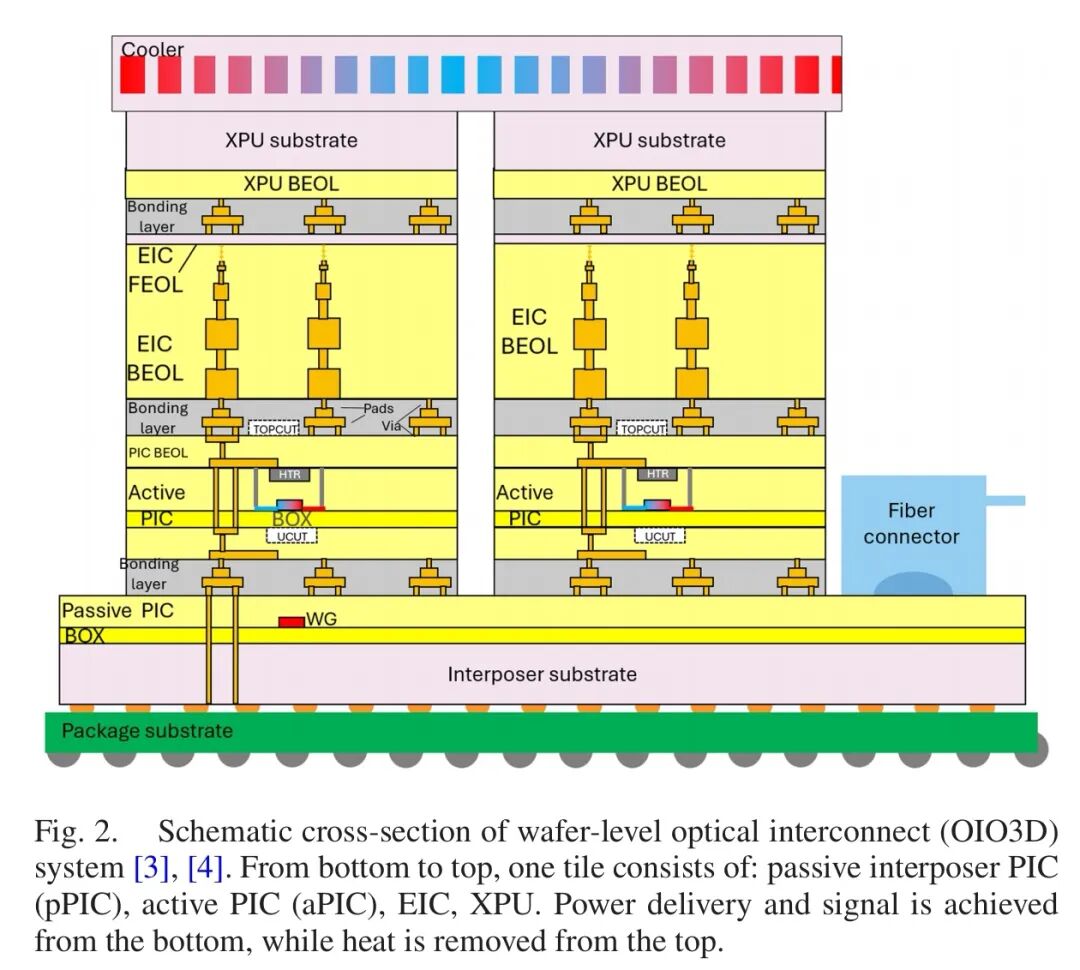
1. 器件级:微盘调制器热模型
微盘调制器(DM)作为核心光调制器件,采用钨(W)加热器实现热调谐,半径范围为2.1-3.5μm,其中2.1μm半径器件因紧凑性与高效性成为重点研究对象。模型包含电光(EO)与热光(TO)驱动的混合键合焊盘,并引入新型热隔离结构TOPCUT。
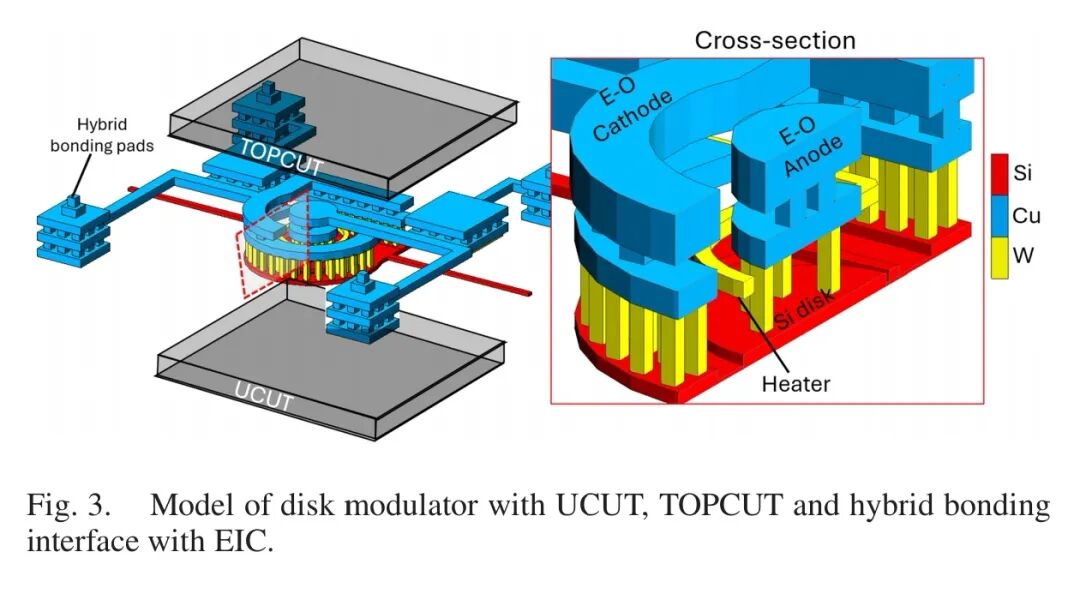
为平衡计算精度与效率,采用局部网格细化策略,仅仿真单个微盘调制器及其铜布线与键合接口,其余焊盘通过等效热阻替代。热仿真基于有限元分析工具Msc Marc,聚焦热传导物理过程,以K/mW为单位输出硅盘平均温度,再结合器件温度系数(∂λ/∂T=62 pm/K),将其转换为实用的加热器效率指标(pm/mW),即ηₕ=∂T/∂P·∂λ/∂T。该模型通过裸片上的加热器效率实测数据完成校准,确保仿真准确性。
2. EIC级:后端金属化层热传导模型
电子集成电路(EIC)的后端金属化层(Back-End-of-Line, BEOL)对垂直热扩散至关重要,其热导率受金属密度、过孔布局显著影响。为实现与设计无关的通用建模,采用经验公式计算等效热导率,考虑线密度(LD)、过孔密度(VD)等关键参数,公式如下:
λ₀=0.3(1+c·VD·LD)
λₑff=λ₀exp([1+(LD/100)ᵅ]ᵝ-1)
其中α=1.691、β=4.561、c=7.78×10⁻¹,LD与VD以百分比表示。仿真采用平均金属密度与随机过孔布局假设,后续通过调整器件上方金属密度验证其对热性能的影响。
3. 晶圆级:全系统热管理模型
OIO3D系统采用300mm晶圆,集成56个25×25mm²的Tile,每个Tile由无源中介层PIC、有源PIC、EIC与700W功率的XPU(CPU/GPU)构成3D堆叠结构。为简化计算,利用对称性将计算域缩减至1/4,不考虑集成激光器、存储模块与光纤连接器。
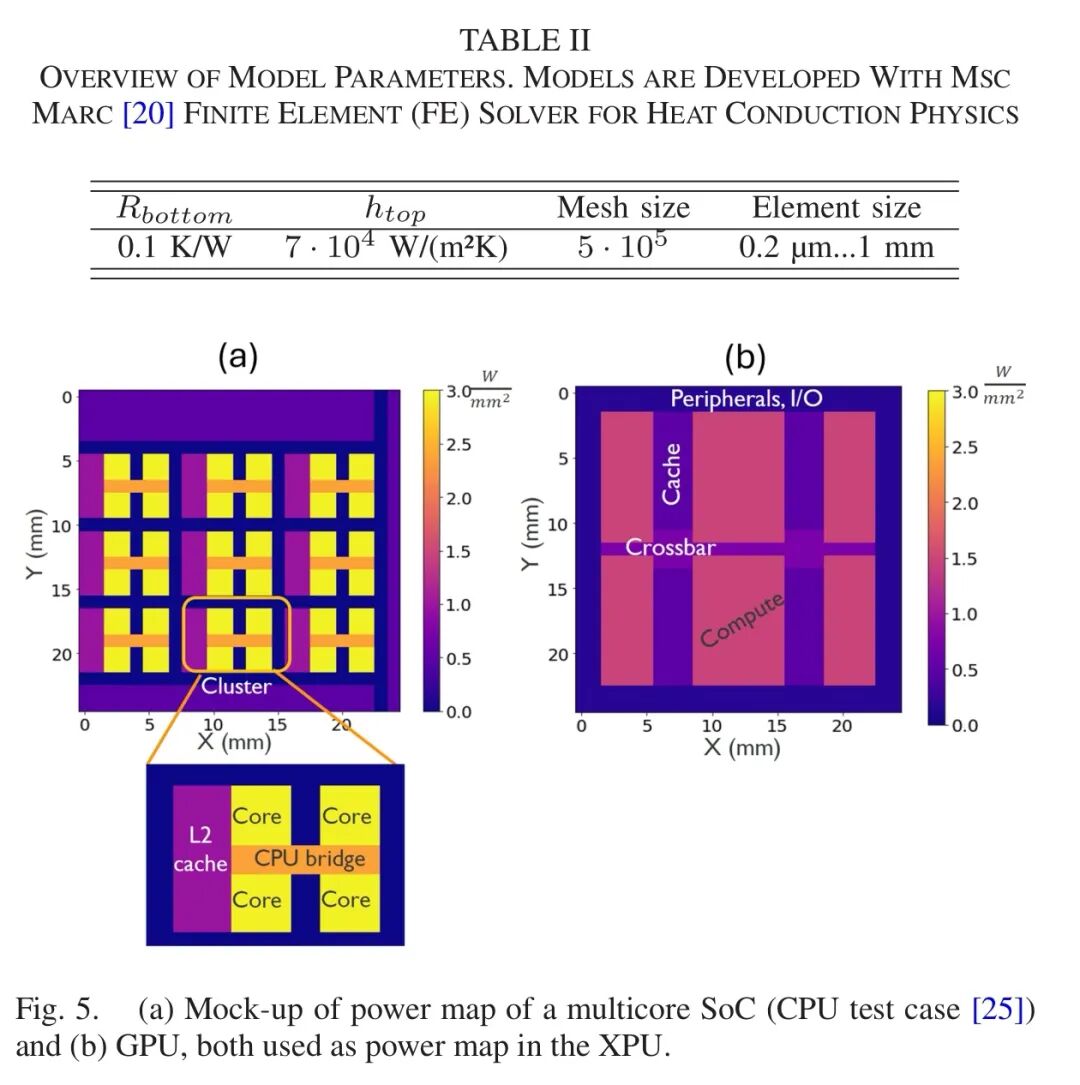
晶圆级热管理依赖顶部液冷冷板,采用与硅中介层热膨胀系数(CTE)匹配的硅微通道晶圆,通过计算流体动力学(CFD)仿真确定对流换热系数为7×10⁴ W/(m²·K);底部散热路径的热阻估算为0.1 K/W,确保大部分热量通过顶部冷板散发。
4. 功率分布设定
系统热量主要来源于XPU,采用两种功率图谱:CPU型(36核,功率密度3 W/mm²)与GPU型(功率分布更均匀,最大功率密度1.8 W/mm²)。光互连相关功耗包括EIC与有源PIC:EIC中所有驱动电路(调谐控制、高速驱动等)的能耗为660 fJ/bit;有源PIC的功耗以加热器为主,单个器件功耗2.8 mW,总功耗按PₐPIC=2×(Bₓₚᵤ/B_cell)×P_device计算,其中XPU总比特率Bₓₚᵤ=400 Tbps,单个单元比特率B_cell=32 Gbps。全晶圆总功率达58.1 kW,散热密度为0.82 W/mm²,处于合理范围。
二、关键热性能结果分析
通过多尺度仿真与实验校准,明确了晶圆级光互连系统中微盘调制器的核心热问题:加热器效率显著损耗与复杂热串扰,同时验证了优化策略的有效性。
1. 加热器效率损耗与优化效果
混合键合技术虽提升了EIC与PIC的集成紧密性,但导致热阻降低,使加热器效率大幅下降——与裸PIC相比,混合键合后的加热器效率损失达42%-62%,这一损耗比采用微凸点(μbumps)的倒装芯片集成更为严重。传统的衬底底切(UCUT)技术因有源PIC衬底被移除,且主要散热路径转向顶部散热器,已无法有效提升加热器效率,需通过新型结构与协同设计改善。

- TOPCUT热隔离结构:通过在混合键合层或PIC的BEOL层中蚀刻腔体(深度100-300nm,尺寸5-15μm),阻断垂直热传导路径。当TOPCUT尺寸与UCUT相当时,加热器效率可提升13%-38%,具体取决于EIC的BEOL设计;若TOPCUT尺寸超过UCUT,热增益会因热量沿最小阻力路径逃逸而边际递减。垂直距离(加热器与TOPCUT间距)对效率影响显著,需根据BEOL层数合理布局。

- EIC BEOL协同设计:通过在微盘调制器正上方设置低金属密度区域,可降低BEOL层的热导率。当低金属密度区域尺寸为50μm时,加热器效率可相对提升12%,进一步扩大区域尺寸则增益饱和。
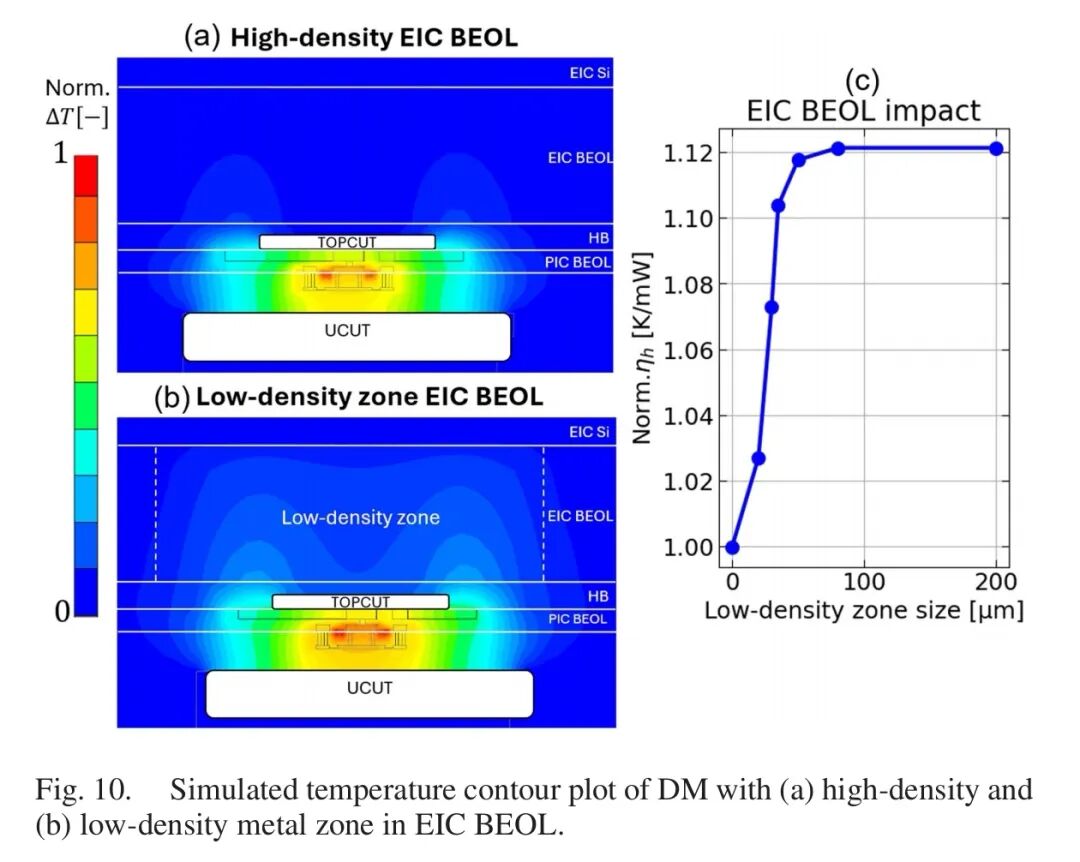
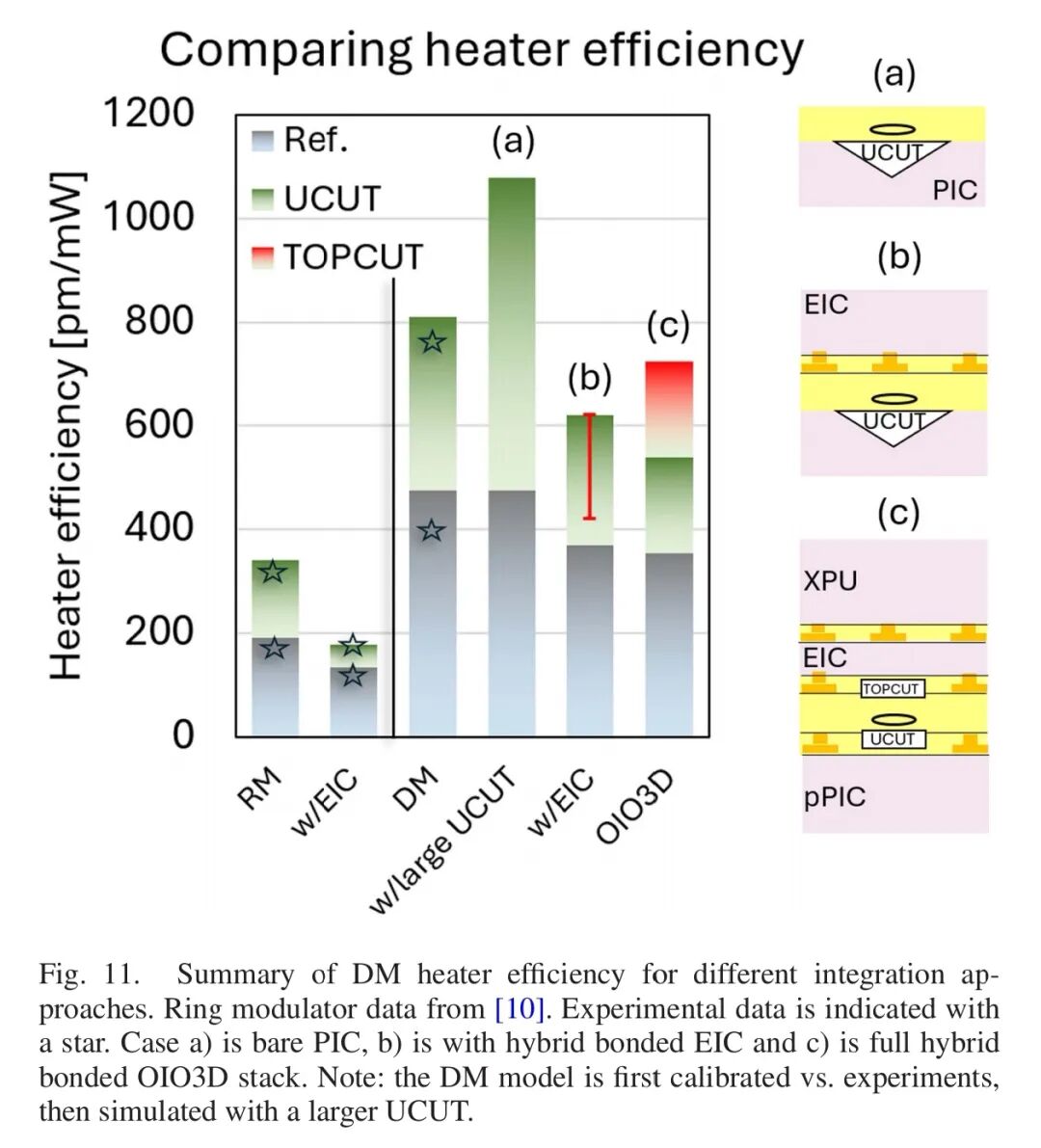
2. 热串扰特性:空间与时间梯度
热串扰分为水平(同层器件间、Tile间)与垂直(层间)两类,其表现与影响存在显著差异:
- 水平热串扰:在有效顶部液冷条件下(h=7×10⁴ W/(m²·K)),Tile间的热串扰极小,距离10mm时串扰系数<10⁻⁵;即使冷却效率下降,串扰增长仍有限,表明Tile间可实现热解耦运行。有源PIC层内的器件间水平串扰同样微弱,距离200μm时串扰系数仅10⁻³,且25000个加热器的累积自加热仅导致PIC层局部温度升高约3K,对器件性能影响可忽略。

- 垂直热串扰与梯度:XPU的功率分布直接影响PIC层温度,垂直热串扰更为显著。CPU型XPU因核心尺寸小、功率密度高,导致PIC层的空间温度梯度达12 K/mm,高于GPU型XPU;且Tile边缘温度因冷却液的热效应高于中心区域。时间维度上,系统启动阶段的热响应显示,XPU功率从0突增至100%时,PIC层的瞬时温度梯度达1.78 K/ms,需快速热调谐补偿。

3. 晶圆级温度分布
冷却液入口温度设定为30℃,温升ΔT=10K,系统自加热导致结温最高达100℃,符合可靠性要求。温度分布呈现中心低、边缘高的特征,与冷却液流动路径一致;CPU型XPU对应的PIC层最高温度高于GPU型,与功率密度分布相符。


三、热挑战应对方案与讨论
为解决加热器效率损耗与快速温度梯度问题,需从器件结构、电路设计与替代技术三方面协同突破。
1. 热调谐控制器性能要求
为补偿1.78 K/ms的瞬时温度梯度,确保调制器波长稳定(波动≤10 pm),热调谐控制器需满足严苛指标:响应时间<84μs、跟踪速度>1.78 K/ms、电流增益42 dB(181 mA/mA)。现有数字控制方案难以达标(如部分方案跟踪速度0.065 K/ms、响应时间1 ms),而基于CMOS工艺的模拟PID控制器已实现突破——22nm工艺下功耗<1 mW,面积仅47×47μm²,具备应用潜力。
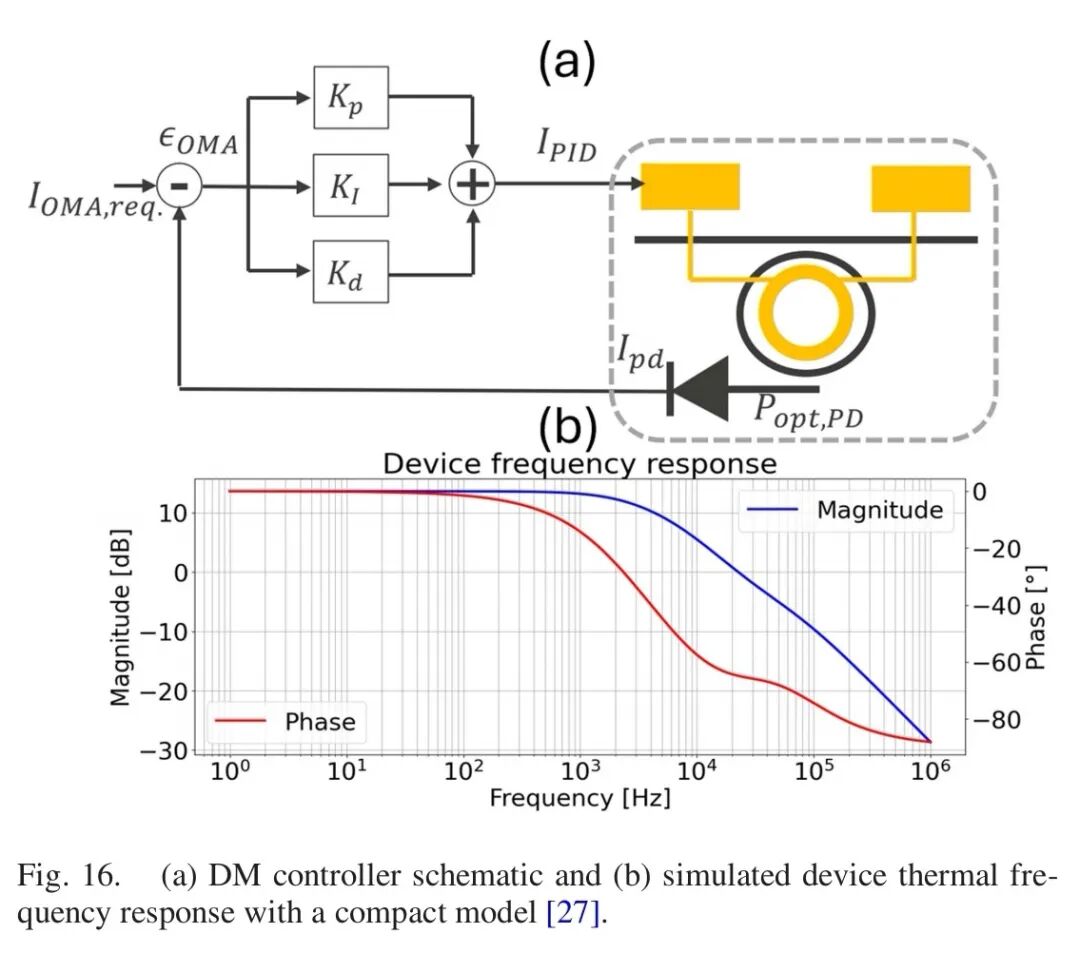

2. 替代调制器技术
若热管理压力无法完全缓解,可采用锗硅(GeSi)电吸收调制器替代微环调制器(RM)或微盘调制器,其对温度变化的耐受性更高,能降低热调谐需求,为系统提供更灵活的设计选择。
四、结论
晶圆级光互连系统为高性能计算提供了高效数据传输解决方案,但硅光子微盘调制器面临的加热器效率损耗与热串扰问题是实现系统可靠运行的关键障碍。通过实验校准的多尺度热仿真,得出以下核心结论:
1. 混合键合导致微盘调制器加热器效率损失42%-62%,传统UCUT技术失效,需依赖TOPCUT热隔离结构(效率提升13%-38%)与EIC BEOL协同设计(效率提升12%)部分抵消损耗;
2. 有效的顶部液冷使Tile间与PIC层内器件间的水平热串扰可忽略,但XPU与PIC间的垂直热串扰显著,导致最大12 K/mm的空间梯度与1.78 K/ms的瞬时梯度;
3. 需采用响应时间<84μs、增益42 dB的模拟PID控制器,或选用GeSi电吸收调制器,以应对严苛的热环境。
本研究为晶圆级光互连系统的热设计提供了量化依据与实用优化方案,助力高性能、高可靠硅光子光互连技术的产业化推进。未来需进一步优化TOPCUT工艺兼容性,并开发更高效的热调谐控制电路,持续提升系统热稳定性
本文参与 腾讯云自媒体同步曝光计划,分享自微信公众号。
原始发表:2025-12-25,如有侵权请联系 cloudcommunity@tencent.com 删除
评论
登录后参与评论
推荐阅读


