[新启航]白光干涉仪在晶圆干法刻蚀工艺后的 3D 轮廓测量
原创[新启航]白光干涉仪在晶圆干法刻蚀工艺后的 3D 轮廓测量
原创
SYNCON新启航
发布于 2025-09-26 16:16:02
发布于 2025-09-26 16:16:02
引言
晶圆干法刻蚀工艺通过等离子体或反应离子对材料进行 anisotropic(各向异性)腐蚀,形成高精度三维结构(如栅极沟槽、通孔、FinFET 鳍片等),其刻蚀深度、线宽均匀性、侧壁粗糙度等参数直接影响器件的电学性能。例如,7nm 节点芯片的栅极沟槽深度偏差若超过 2nm,会导致器件阈值电压漂移 10% 以上;3D NAND 的堆叠结构刻蚀不均会引发存储单元失效。传统测量方法中,扫描电镜(SEM)需破坏性取样且无法实现全域三维测量;原子力显微镜(AFM)效率低,难以覆盖 12 英寸晶圆的工艺均匀性评估。白光干涉仪凭借非接触、纳米级精度、大面积三维成像的特性,成为干法刻蚀后轮廓测量的核心工具,为等离子体功率优化、刻蚀气体配比调整提供关键数据支撑。
晶圆干法刻蚀后测量的核心需求
晶圆干法刻蚀后测量需满足三项关键指标:一是各向异性结构参数表征,需同步获取刻蚀深度(误差 <±1nm)、侧壁倾角(偏差 <±0.1°)、线宽缩小量(CD loss,精度 <±0.5nm),尤其需捕捉等离子体不均匀导致的侧壁波纹(周期 < 100nm);二是全域工艺均匀性分析,需覆盖 12 英寸晶圆的多个刻蚀区域,确保深度均匀性 3σ<2nm,线宽均匀性 3σ<1.5nm;三是等离子体损伤检测,需识别刻蚀过程中因离子轰击导致的表面损伤层(厚度 < 5nm),单晶圆测量时间 < 15 分钟,且兼容硅、SiGe、金属等多种刻蚀材料。
接触式探针易导致高宽比结构(如深宽比 > 15 的 FinFET 鳍片)坍塌,光学轮廓仪无法区分表面损伤层与真实刻蚀轮廓,均无法满足需求。白光干涉仪的技术特性恰好适配这些测量难点。
白光干涉仪的技术适配性
各向异性结构的三维重建能力
白光干涉仪的垂直分辨率达 0.1nm,横向分辨率 0.3μm,通过垂直扫描干涉(VSI)与光谱干涉(SI)复合模式,可清晰重建深宽比 20:1 的干法刻蚀结构。其采用的侧壁轮廓提取算法能精准区分水平表面与垂直侧壁,计算侧壁倾角(重复性误差 < 0.05°)和粗糙度(Ra<0.3nm);通过分层线宽分析技术,量化不同深度的 CD loss(如顶部线宽 30nm,底部线宽 29.2nm)。例如,对 500nm 深的硅沟槽,可识别等离子体刻蚀导致的侧壁周期性波纹(振幅 < 2nm),为调整射频功率提供依据。
多材料与损伤层的信号适配性
针对干法刻蚀涉及的硅(反射率 35%)、TiN(反射率 60%)、SiO₂(反射率 4%)等材料,白光干涉仪可通过调整光源波段(400-700nm)和检测模式(反射 / 散射)优化信号质量。其高灵敏度探测器(噪声等效功率 < 10⁻¹⁴W/Hz¹/²)能捕捉损伤层导致的纳米级表面起伏,结合薄膜干涉模型可区分损伤层厚度(测量误差 < 0.5nm)与刻蚀深度。非接触测量模式避免了对脆性刻蚀结构的机械损伤,对高宽比 15:1 的纳米柱阵列,测量后无结构倒伏现象。
高效全域检测能力
通过精密气浮平台的拼接扫描技术,白光干涉仪可在 12 分钟内完成 12 英寸晶圆的全域三维成像,生成刻蚀参数的空间分布热力图。结合机器学习算法,能自动识别刻蚀缺陷(如底部残留、侧壁锥度突变),统计缺陷密度并关联等离子体分布不均区域。软件支持多批次晶圆的参数对比,量化刻蚀工艺的长期漂移(如每日深度偏差 < 0.3nm)。
具体测量流程与关键技术
测量系统配置
需配备高数值孔径物镜(NA=0.95)与长工作距离设计(≥10mm),兼顾分辨率与结构兼容性;采用高稳定性白光光源(功率波动 < 0.1%),支持波段切换(450nm 适配硅,635nm 适配氧化物);Z 向扫描范围≥10μm,步长 0.5nm 以覆盖深槽结构。测量前用标准干法刻蚀样板(含 1μm 深沟槽、50nm 线宽)校准,确保深度测量偏差 < 0.5nm。
数据采集与处理流程
晶圆经真空吸附固定在防震载物台后,系统通过 Mark 点定位刻蚀区域,扫描获取三维干涉数据。数据处理包括三步:一是背景校正,去除晶圆翘曲与全局倾斜对深度测量的影响;二是参数提取,计算深度、线宽、侧壁倾角、损伤层厚度等参数;三是工艺分析,与刻蚀标准比对,标记超差区域(如深度偏差 > 3nm 的区域)。
典型应用案例
在 5nm FinFET 鳍片刻蚀测量中,白光干涉仪检测出晶圆边缘鳍片高度比中心低 5nm(设计高度 150nm),侧壁倾角偏差 0.8°,追溯为边缘等离子体密度不足,调整磁场分布后高度均匀性提升至 3σ=1.2nm。在 DRAM 深沟槽刻蚀测量中,发现底部存在 2nm 高的残留凸起,通过优化刻蚀气体配比(增加 CF₄比例 5%),残留缺陷率从 3‰降至 0.1‰。
应用中的挑战与解决方案
高陡度侧壁的信号衰减
当侧壁倾角 > 89° 时,反射信号弱导致轮廓重建失真。采用多角度照明(±20°)与信号融合算法,可将侧壁数据完整度提升至 98%,倾角测量误差控制在 ±0.05°。
等离子体损伤层的干扰
损伤层与刻蚀表面的高度差 < 5nm 时易导致深度误判。通过双波段干涉(450nm+635nm)技术分离损伤层信号,可将深度测量误差控制在 0.5nm 以内。
大视野 3D 白光干涉仪:纳米级测量全域解决方案
突破传统局限,定义测量新范式!大视野 3D 白光干涉仪凭借创新技术,一机解锁纳米级全场景测量,重新诠释精密测量的高效精密。

三大核心技术革新
1)智能操作革命:告别传统白光干涉仪复杂操作流程,一键智能聚焦扫描功能,轻松实现亚纳米精度测量,且重复性表现卓越,让精密测量触手可及。
2)超大视野 + 超高精度:搭载 0.6 倍镜头,拥有 15mm 单幅超大视野,结合 0.1nm 级测量精度,既能满足纳米级微观结构的精细检测,又能无缝完成 8 寸晶圆 FULL MAPPING 扫描,实现大视野与高精度的完美融合。
3)动态测量新维度:可集成多普勒激光测振系统,打破静态测量边界,实现 “动态” 3D 轮廓测量,为复杂工况下的测量需求提供全新解决方案。
实测验证硬核实力
1)硅片表面粗糙度检测:凭借优于 1nm 的超高分辨率,精准捕捉硅片表面微观起伏,实测粗糙度 Ra 值低至 0.7nm,为半导体制造品质把控提供可靠数据支撑。
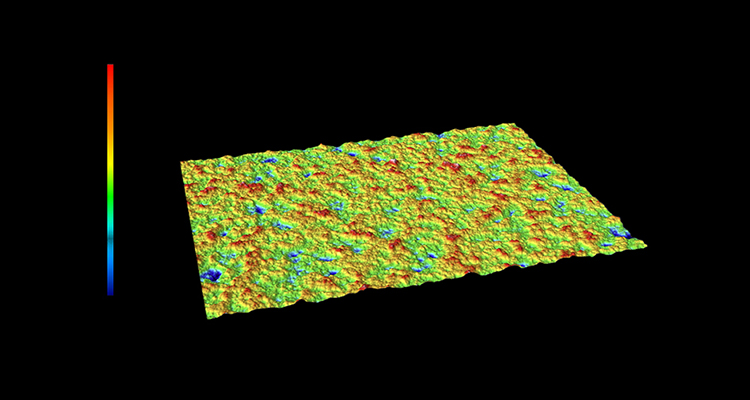
(以上数据为新启航实测结果)
有机油膜厚度扫描:毫米级超大视野,轻松覆盖 5nm 级有机油膜,实现全区域高精度厚度检测,助力润滑材料研发与质量检测。

高深宽比结构测量:面对深蚀刻工艺形成的深槽结构,展现强大测量能力,精准获取槽深、槽宽数据,解决行业测量难题。
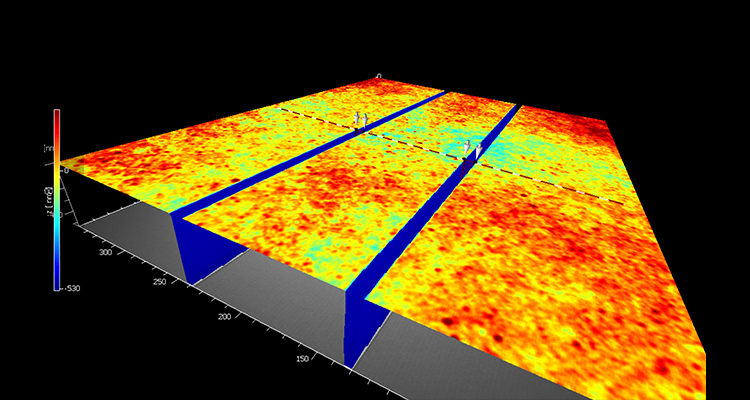
分层膜厚无损检测:采用非接触、非破坏测量方式,对多层薄膜进行 3D 形貌重构,精准分析各层膜厚分布,为薄膜材料研究提供无损检测新方案。
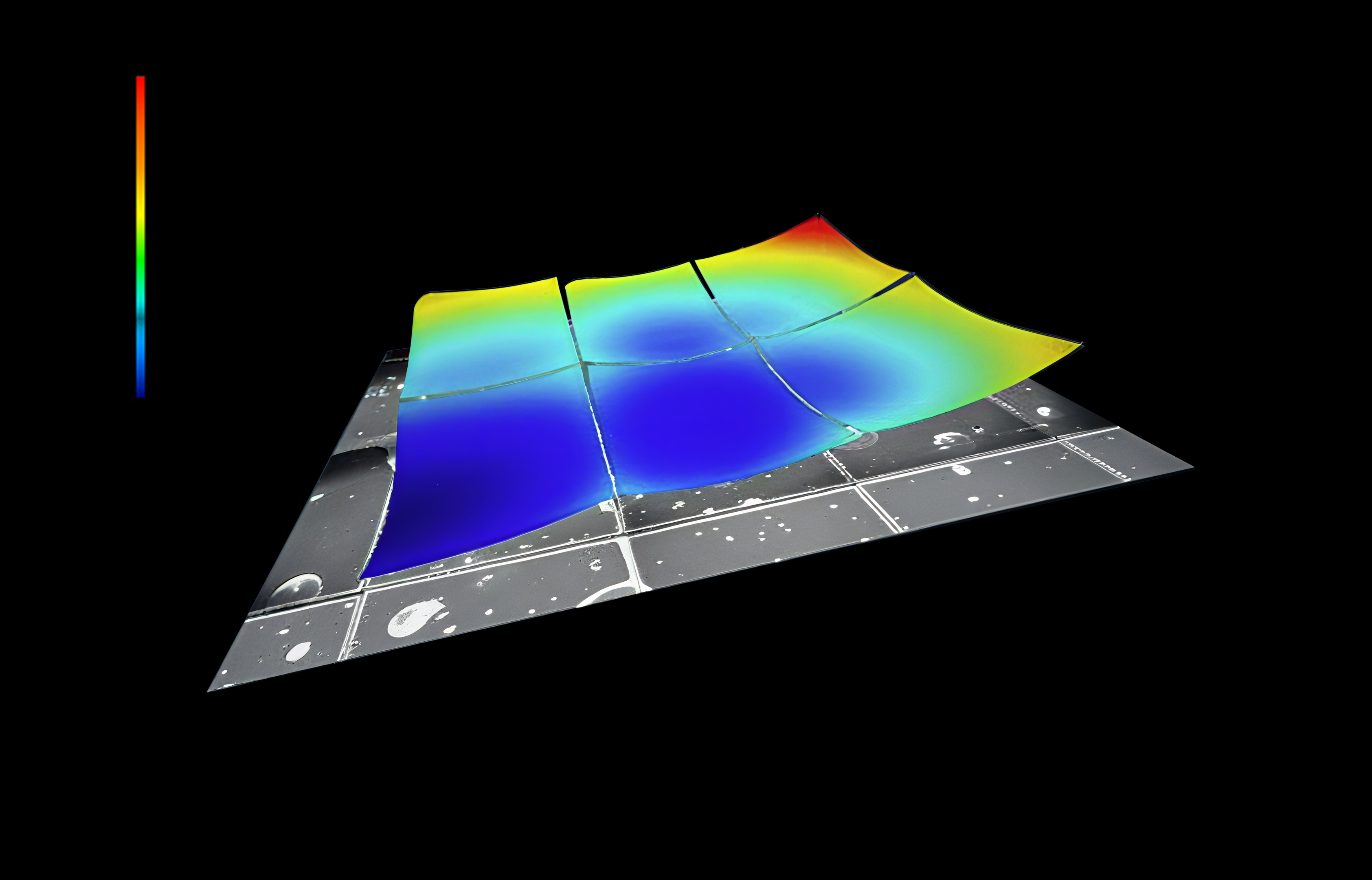
新启航半导体,专业提供综合光学3D测量解决方案!
原创声明:本文系作者授权腾讯云开发者社区发表,未经许可,不得转载。
如有侵权,请联系 cloudcommunity@tencent.com 删除。
原创声明:本文系作者授权腾讯云开发者社区发表,未经许可,不得转载。
如有侵权,请联系 cloudcommunity@tencent.com 删除。
评论
登录后参与评论
推荐阅读

